陶瓷基板七大制备技术
陶瓷基板用技术不同命名有七大种类,今天小编就来详细阐述一下这个七大技术的原理,制备原理、工艺流程、技术特点和具体应用以及发展趋势。
陶瓷基板发展的背景
第一代半导体以硅 (Si)、锗 (Ge) 材料为代表,主要应用在数据运算领域,奠定了微电子产业基础。第二代半导体以砷化镓 (GaAs)、磷化铟 (InP) 为代表,主要应用于通信领域,用于制作高性能微波、毫米波及发光器件,奠定了信息产业基础。随着技术发展和应用需要的不断延伸,二者的局限性逐渐体现出来,难以满足高频、高温、高功率、高能效、耐恶劣环境以及轻便小型化等使用需求。以碳化硅 (SiC) 和氮化镓 (GaN) 为代表的第三代半导体材料具有禁带宽度大、临界击穿电压高、热导率高、载流子饱和漂移速度大等特点,其制作的电子器件可在 300°C 甚至更高温度下稳定工作 (又称为功率半导体或高温半导体),是固态光源 (如 LED)、激光器 (LD)、电力电子 (如IGBT)、聚焦光伏 (CPV)、微波射频 (RF) 等器件的“核芯”,在半导体照明、汽车电子、新一代移动通信 (5G)、新能源与新能源汽车、高速轨道交通、消费类电子等领域具有广阔的应用前景,有望突破传统半导体技术瓶颈,与第一代、第二代半导体技术互补,在光电器件、电力电子、汽车电子、航空航天、深井钻探等领域具有重要应用价值,对节能减排、产业转型升级、催生新经济增长点将发挥重要作用。

伴随着功率器件 (包括 LED、LD、IGBT、CPV 等) 不断发展,散热成为影响器件性能与可靠性的关键技术。对于电子器件而言,通常温度每升高 10°C,器件有效寿命就降低 30% ~ 50%。因此,选用合适的封装材料与工艺、提高器件散热能力就成为发展功率器件的技术瓶颈。以大功率 LED 封装为例,由于输入功率的 70% ~ 80% 转变成为热量 (只有约 20% ~ 30% 转化为光能),且 LED 芯片面积小,器件功率密度很大 (大于 100 W/cm2),因此散热成为大功率 LED 封装必须解决的关键问题。如果不能及时将芯片发热导出并消散,大量热量将聚集在 LED 内部,芯片结温将逐步升高,一方面使 LED 性能降低 (如发光效率降低、波长红移等),另一方面将在 LED 器件内部产生热应力,引发一系列可靠性问题 (如使用寿命、色温变化等)。
陶瓷基板的七大技术类型
随着功率器件特别是第三代半导体的崛起与应用,半导体器件逐渐向大功率、小型化、集成化、多功能等方向发展,对封装基板性能也提出了更高要求。陶瓷基板 (又称陶瓷电路板) 具有热导率高、耐热性好、热膨胀系数低、机械强度高、绝缘性好、耐腐蚀、抗辐射等特点,在电子器件封装中得到广泛应用。本文分析了常用陶瓷基片材料 (包括 Al2O3、AlN、Si3N4、BeO、SiC 和 BN 等) 的物理特性,重点对各种陶瓷基板 (包括薄膜陶瓷基板 TFC、厚膜印刷陶瓷基板 TPC、直接键合陶瓷基板 DBC、直接电镀陶瓷基板 DPC、活性金属焊接陶瓷基板AMB、激光活化金属陶瓷基板 LAM 以及各种三维陶瓷基板等) 。
陶瓷基板制备技术
陶瓷基板又称陶瓷电路板,包括陶瓷基片和金属线路层。对于电子封装而言,封装基板起着承上启下,连接内外散热通道的关键作用,同时兼有电互连和机械支撑等功能。陶瓷具有热导率高、耐热性好、机械强度高、热膨胀系数低等优势,是功率半导体器件封装常用的基板材料。根据封装结构和应用要求,陶瓷基板可分为平面陶瓷基板和三维陶瓷基板两大类。
2.1 平面陶瓷基板
根据制备原理与工艺不同,平面陶瓷基板可分为薄膜陶瓷基板 (Thin Film Ceramic Substrate,TFC)、厚膜印刷陶瓷基板 (ThickPrinting Ceramic Substrate, TPC)、直接键合铜陶瓷基板 (Direct Bonded Copper Ceramic Substrate, DBC)、活性金属焊接陶瓷基板(Active Metal Brazing Ceramic Substrate, AMB)、直接电镀铜陶瓷基板(Direct Plated Copper Ceramic Substrate, DPC) 和激光活化金属陶瓷基板 (LaserActivated Metallization Ceramic Substrate, LAM) 等。
薄膜陶瓷基板 (TFC)的制备原理、工艺流程和技术特点
薄膜陶瓷基板一般采用溅射工艺直接在陶瓷基片表面沉积金属层。如果辅助光刻、显影、刻蚀等工艺,还可将金属层图形化制备成线路,如图 6 所示。由于溅射镀膜沉积速度低 (一般低于 1 μm/h),因此 TFC 基板表面金属层厚度较小 (一般小于 1 μm),可制备高图形精度 (线宽/线距小于 10 μm) 陶瓷基板,主要应用于激光与光通信领域小电流器件封装。
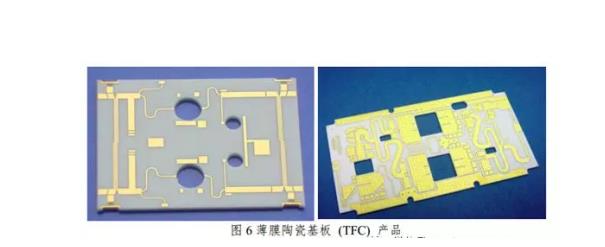
厚膜印刷陶瓷基板 (TPC)技术工艺和特点
通过丝网印刷将金属浆料涂覆在陶瓷基片上,干燥后经高温烧结 (温度一般在 850°C ~ 900°C) 制备 TPC 基板,其工艺流程如图 7 所示。根据金属浆料粘度和丝网网孔尺寸不同,制备的金属线路层厚度一般为 10 μm ~ 20 μm (提高金属层厚度可通过多次丝网印刷实现)。TFC 基板制备工艺简单,对加工设备和环境要求低,具有生产效率高、制造成本低等优点。但是,由于丝网印刷工艺限制,TFC 基板无法获得高精度线路 (最小线宽/线距一般大于 100 μm)。此外,为了降低烧结温度,提高金属层与陶瓷基片结合强度,通常在金属浆料中添加少量玻璃相,这将降低金属层电导率和热导率。因此 TPC 基板仅在对线路精度要求不高的电子器件 (如汽车电子) 封装中得到应用。TPC 基板样品及其截面图如图 8 所示。
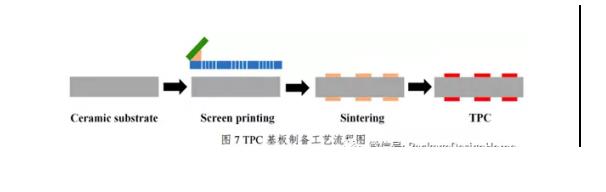
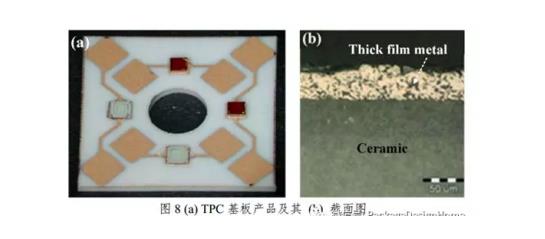
目前 TPC 基板关键技术在于制备高性能金属浆料。金属浆料主要由金属粉末、有机载体和玻璃粉等组成。浆料中可供选择的导体金属有 Au、Ag、Ni、Cu 和 Al 等。银基导电浆料因其具有较高的导电、导热性能及相对低廉的价格而应用广泛 (占金属浆料市场 80% 以上份额)。研究表明,银颗粒粒径颗粒粒径、形貌等对导电层性能影响很大。如Park等人通过加入适量纳米银颗粒降低了银浆电阻率:Zhou等人指出金属层电阻率随着球状银颗粒尺寸减小而降低,片状银粉(尺寸6m)制备的金属浆料电阻率远小于同样尺寸球状银粉制备的浆料。
直接键合陶瓷基板(DBC)工艺流程和技术特点
DBC陶瓷基板制备首先在铜箔(Cu)和陶瓷基片(Al2O3或AN间引入氧元素,然后在1065°C形成CuO共晶相(金属铜熔点为1083°C),进而与陶瓷基片和铜箔发生反应生成CuAO2或Cu(AO2)2,实现铜箔与陶瓷间共晶键合,其制备工艺和产品分别如图9和图10所示。由于陶瓷和铜具有良好的导热性,且铜箔与陶瓷间共晶键合强度高,因此DBC基板具有较高的热稳定性,已广泛应用于绝缘栅双极二极管(GBT)、激光器(LD)和聚焦光伏(CPV)等器件封装散热中。
DBC基板铜箔厚度较大(一般为100μm-600μm),可满足高温、大电流等极端环境下器件封装应用需求(为降低基板应力与制曲,一船采用C1-A1O2C的三明治结构.日上下铜层厚度相同)
虽然DBC基板在实际应用中有诸多优势,但在制备过程中要严格控制共晶温度及氧含量,对设备和工艺控制要求较高,生产成本也较高。
此外,由于厚铜刻蚀限制,无法制备出高精度线路层在DBC基板制备过程中,氧化时间和氧化温度是最重要的两个参数。铜箔经预氧化后,键合界面能形成足够 CuxOy 相润湿 Al2O3 陶瓷与铜箔,具有较高的结合强度;若铜箔未经过预氧化处理,CuxOy 润湿性较差,键合界面会残留大量空洞和缺陷,降低结合强度及热导率。对于采用 AlN 陶瓷制备 DBC 基板,还需对陶瓷基片进行预氧化,先生成 Al2O3 薄膜,再与铜箔发生共晶反应。谢建军等人用 DBC 技术制备 Cu/Al2O3、Cu/AlN 陶瓷基板,铜箔和 AlN 陶瓷间结合强度超过 8 N/mm,铜箔和 AlN 间存在厚度为 2 μm 的过渡层,其成分主要为 Al2O3、CuAlO2 和 Cu2O。

目前,制备活性焊料是 AMB 基板制备关键技术。活性焊料的最初报道是 1947 年 Bondley 采用TiH2 活性金属法连接陶瓷与金属,在此基础上,Bender 等人提出 Ag-Cu-Ti 活性焊接法。活性焊料主要分为高温活性焊料 (活性金属为 Ti、V 和 Mo 等,焊接温度 1000°C ~ 1250°C)、中温活性焊料(活性金属为 Ag-Cu-Ti,焊接温度 700°C ~ 800°C,保护气体或真空下焊接) 和低温活性焊料 (活性金属为 Ce、Ga 和 Re,焊接温度 200°C ~ 300°C)。中高温活性焊料成分简单,操作容易,焊接界面机械强度高,在金属-陶瓷焊接中得到广泛应用。Naka 等人分别采用 Cu60Ti34 活性焊料焊接 Si3N4陶瓷和 NiTi50 活性焊料焊接 SiC,前者室温下焊接界面剪切强度达到 313.8 MPa,而后者在室温、300°C和 700°C 时的焊接界面剪切强度分别为 158 MPa、316 MPa 和 260 MPa。
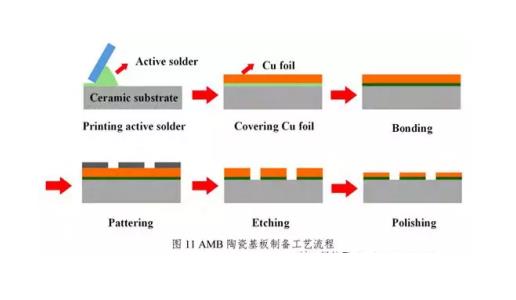
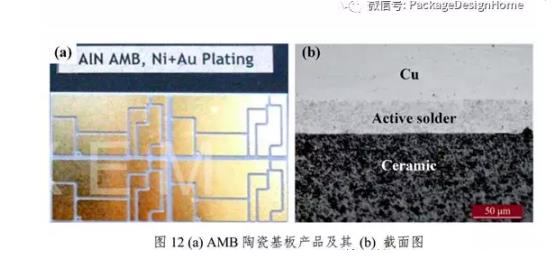
由于 DBC 陶瓷基板制备工艺温度高,金属-陶瓷界面应力大,因此 AMB 技术越来越受到业界关注,特别是采用低温活性焊料。如 Chang 等人使用 Sn3.5Ag4Ti(Ce,Ga) 活性焊料在 250°C 下分别实现了 ZnS-SiO2、ITO 陶瓷以及 Al2O3 陶瓷与 Cu 层焊接;Tsao 等人使用 Sn3.5Ag4Ti(Ce) 活性焊料实现了 Al 与微亚弧氧化铝 (MAO-Al) 间焊接。
直接电镀陶瓷基板 (DPC)技术工艺和特点
DPC 陶瓷基板制备工艺如图 13 所示。首先利用激光在陶瓷基片上制备通孔 (孔径一般为 60 μm ~ 120 μm),随后利用超声波清洗陶瓷基片;采用磁控溅射技术在陶瓷基片表面沉积金属种子层 (Ti/Cu),接着通过光刻、显影完成线路层制作;采用电镀填孔和增厚金属线路层,并通过表面处理提高基板可焊性与抗氧化性,最后去干膜、刻蚀种子层完成基板制备。
从图 13 可以看出,DPC 陶瓷基板制备前端采用了半导体微加工技术 (溅射镀膜、光刻、显影等),后端则采用了印刷线路板 (PCB) 制备技术 (图形电镀、填孔、表面研磨、刻蚀、表面处理等),技术优势明显。具体特点包括:(1) 采用半导体微加工技术,陶瓷基板上金属线路更加精细 (线宽/线距可低至 30 μm ~ 50 μm,与线路层厚度相关),因此 DPC 基板非常适合对准精度要求较高的微电子器件封装;(2) 采用激光打孔与电镀填孔技术,实现了陶瓷基板上/下表面垂直互联,可实现电子器件三维封装与集成,降低器件体积,如图 14 (b) 所示;(3) 采用电镀生长控制线路层厚度 (一般为 10 μm ~ 100 μm),并通过研磨降低线路层表面粗糙度,满足高温、大电流器件封装需求;(4) 低温制备工艺 (300°C 以下) 避免了高温对基片材料和金属线路层的不利影响,同时也降低了生产成本。综上所述,DPC 基板具有图形精度高,可垂直互连等特性,是一种真正的陶瓷电路板。
但是,DPC 基板也存在一些不足:(1) 金属线路层采用电镀工艺制备,环境污染严重;(2) 电镀生长速度低,线路层厚度有限 (一般控制在 10 μm ~ 100 μm),难以满足大电流功率器件封装需求。目前 DPC 陶瓷基板主要应用于大功率 LED 封装,生产厂家主要集中在我国台湾地区,但从 2015 年开始大陆地区已开始实现量产。
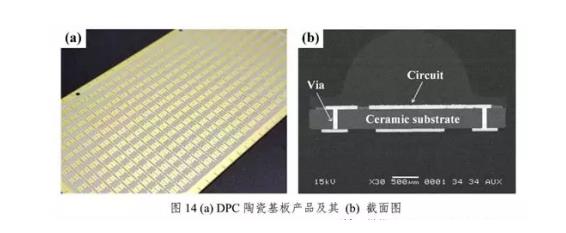
金属线路层与陶瓷基片的结合强度是影响 DPC 陶瓷基板可靠性的关键。由于金属与陶瓷间热膨胀系数差较大,为降低界面应力,需要在铜层与陶瓷间增加过渡层,从而提高界面结合强度。由于过渡层与陶瓷间的结合力主要以扩散附着及化学键为主,因此常选择 Ti、Cr 和 Ni 等活性较高、扩散性好的金属作为过渡层 (同时作为电镀种子层)。Lim 等人采用 50 W 的 Ar 等离子束对 Al2O3 基片清洗 10 min,随后再溅射 1 μm ± 0.2 μm 的铜薄膜,二者粘结强度高于 34 MPa,而未进行等离子清洗的基片与铜薄膜的粘结强度仅为 7 MPa。占玙娟在溅射 Ti/Ni (其厚度分别为 200 nm 与 400 nm)薄膜之前,采用 600 eV、700 mA 的低能离子束对 AlN 陶瓷基片清洗 15 min,所得到的金属薄膜与陶瓷基片的粘结强度大于 30 MPa。可以看出,对陶瓷基片进行等离子清洗可大大提高与金属薄膜间的结合强度,这主要是因为:(1) 离子束去除了陶瓷基片表面的污染物;(2) 陶瓷基片因受到离子束的轰击而产生悬挂键,与金属原子结合更紧密。
电镀填孔也是 DPC 陶瓷基板制备的关键技术。目前 DPC 基板电镀填孔大多采用脉冲电源,其技术优势包括:(1) 易于填充通孔,降低孔内镀层缺陷;(2) 表面镀层结构致密,厚度均匀;(3) 可采用较高电流密度进行电镀,提高沉积效率。陈珍等人采用脉冲电源在 1.5 ASD 电流密度下电镀2 h,实现了深宽比为 6.25 的陶瓷通孔无缺陷电镀。但脉冲电镀成本高,因此近年来新型直流电镀又重新得到重视,通过优化电镀液配方 (包括整平剂、抑制剂等),实现盲孔或通孔高效填充。如林金堵等人通过优化电镀添加剂、搅拌强度及方式和电流参数,实现了通孔与盲孔电镀。
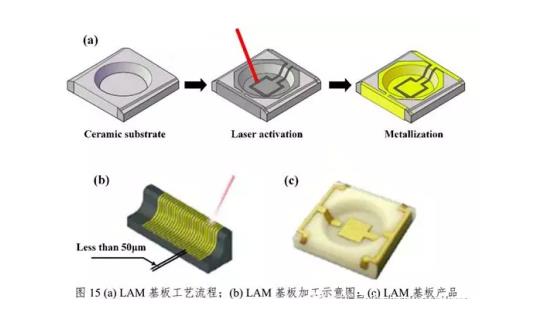
激光活化金属陶瓷基板 (LAM)工艺流程和技术特点
LAM 基板制备利用特定波长的激光束选择性加热活化陶瓷基片表面,随后通过电镀/化学镀完成线路层制备,工艺流程如图 15 (a) 所示。其技术优势包括:(1) 无需采用光刻、显影、刻蚀等微加工工艺,通过激光直写制备线路层,且线宽由激光光斑决定,精度高 (可低至 10 μm ~ 20 μm),如图 15 (b) 所示;(2) 可在三维结构陶瓷表面制备线路层,突破了传统平面陶瓷基板金属化的限制,如图 15 (c) 所示;(3) 金属层与陶瓷基片结合强度高,线路层表面平整,粗糙度在纳米级别。从上可以看出,虽然 LAM 技术可在平面陶瓷基板或立体陶瓷结构上加工线路层,但其线路层由激光束“画”出来,难以大批量生产,导致价格极高,目前主要应用在航空航天领域异型陶瓷散热件加工。
表 2 对不同工艺制备的平面陶瓷基板性能进行了对比。
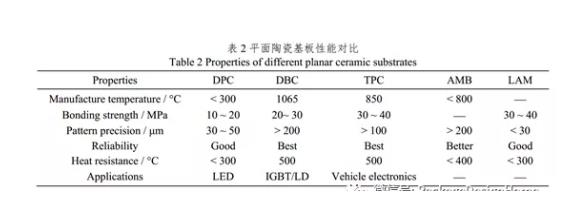
2.2 三维陶瓷基板制备技术工艺和特点
许多微电子器件 (如加速度计、陀螺仪、深紫外 LED 等) 芯片对空气、湿气、灰尘等非常敏感。如 LED 芯片理论上可工作 10 万小时以上,但水汽侵蚀会大大缩短其寿命 (甚至降低至几千小时)。为了提高这些微电子器件性能 (特别是可靠性),必须将其芯片封装在真空或保护气体中,实现气密封装 (芯片置于密闭腔体中,与外界氧气、湿气、灰尘等隔绝)。因此,必须首先制备含腔体 (围坝)结构的三维基板,满足封装应用需求。目前,常见的三维陶瓷基板主要有:高/低温共烧陶瓷基板(High/Low Temperature Co-fired Ceramic Substrate, HTCC/LTCC) 、 多 层 烧 结 三 维 陶 瓷 基 板 (MultilayerSintering Ceramic Substrate,MSC)、直接粘接三维陶瓷基板 (Direct Adhere Ceramic Substrate,DAC)、多层镀铜三维陶瓷基板(Multilayer Plated Ceramic Substrate,MPC) 以及直接成型三维陶瓷基板(Direct Molding Ceramic Substrate,DMC) 等。
高/低温共烧陶瓷基板 (HTCC/LTCC):HTCC 基板制备过程中先将陶瓷粉 (Al2O3 或 AlN) 加入有机黏结剂,混合均匀后成为膏状陶瓷浆料,接着利用刮刀将陶瓷浆料刮成片状,再通过干燥工艺使片状浆料形成生胚;然后根据线路层设计钻导通孔,采用丝网印刷金属浆料进行布线和填孔,最后将各生胚层叠加,置于高温炉 (1600°C) 中烧结而成,如图 16 所示。由于 HTCC 基板制备工艺温度高,因此导电金属选择受限,只能采用熔点高但导电性较差的金属 (如 W、Mo 及 Mn 等),制作成本较高。此外,受到丝网印刷工艺限制,HTCC 基板线路精度较差,难以满足高精度封装需求。但 HTCC 基板具有较高机械强度和热导率 [20 W/(m·K) ~ 200 W/(m·K)],物化性能稳定,适合大功率及高温环境下器件封装,如图 17 (a) 所示。Cheah 等人将 HTCC 工艺应用于微型蒸汽推进器,制备的微型加热器比硅基推进器效率更高,能耗降低 21%以上。
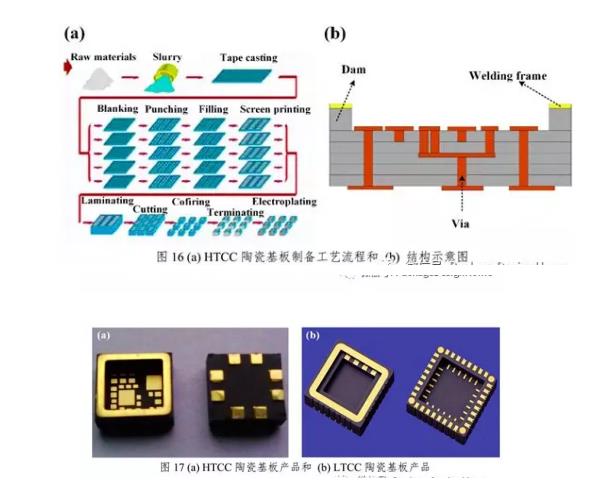
为了降低 HTCC 制备工艺温度,同时提高线路层导电性,业界开发了 LTCC 基板。与 HTCC 制备工艺类似,只是 LTCC 制备在陶瓷浆料中加入了一定量玻璃粉来降低烧结温度,同时使用导电性良好的 Cu、Ag 和 Au 等制备金属浆料,如图 17 (b) 所示。LTCC 基板制备温度低,但生产效率高,可适应高温、高湿及大电流应用要求,在军工及航天电子器件中得到广泛应用。Yuan 等人选用CaO-BaO-Al2O3-B2O3-SiO2/AlN 体系原料,当 AlN 组分含量为 40% 时,研制的 LTCC 基板热导率为 5.9W/(m·K),介电常数为 6.3,介电损耗为 4.9 × 10-3,弯曲强度高达 178 MPa。Qing 等人采用Li2O-Al2O3-SiO2/Al2O3 体系原料,制备的 LTCC 基板抗弯强度为 155 MPa,介电损耗为 2.49 × 10-3。
虽然 LTCC 基板具有上述优势,但由于在陶瓷浆料中添加了玻璃粉,导致基板热导率偏低 [一般仅为 3 W/(m·K) ~ 7 W/(m·K)]。此外,与 HTCC 一样,由于 LTCC 基板采用丝网印刷技术制作金属线路,有可能因张网问题造成对位误差,导致金属线路层精度低;而且多层陶瓷生胚叠压烧结时还存在收缩比例差异问题,影响成品率,一定程度上制约了 LTCC 基板技术发展。Yan 等人经过表面处理将 LTCC 基板翘曲由 150 μm ~ 250 μm 降低至 80 μm ~ 110 μm;Sim 等人通过改进 LTCC基板封装形式,去掉芯片与金属基底间绝缘层,模拟和实验结果显示其热阻降低为 7.3 W/(m·K),满足大功率 LED 封装需求。
多层烧结三维陶瓷基板 (MSC)技术工艺和特点
与 HTCC/LTCC 基板一次成型制备三维陶瓷基板不同,台湾阳升公司采用多次烧结法制备了 MSC 基板。其工艺流程如图 18 所示,首先制备厚膜印刷陶瓷基板(TPC),随后通过多次丝网印刷将陶瓷浆料印刷于平面 TPC 基板上,形成腔体结构,再经高温烧结而成,得到的 MSC 基板样品如图 19 所示。由于陶瓷浆料烧结温度一般在 800°C 左右,因此要求下部的 TPC 基板线路层必须能耐受如此高温,防止在烧结过程中出现脱层或氧化等缺陷。由上文可知,TPC 基板线路层由金属浆料高温烧结 (一般温度为 850°C ~ 900°C) 制备,具有较好的耐高温性能,适合后续采用烧结法制备陶瓷腔体。MSC 基板技术生产设备和工艺简单,平面基板与腔体结构独立烧结成型,且由于腔体结构与平面基板均为无机陶瓷材料,热膨胀系数匹配,制备过程中不会出现脱层、翘曲等现象。其缺点在于,下部 TPC 基板线路层与上部腔体结构均采用丝网印刷布线,图形精度较低;同时,因受丝网印刷工艺限制,所制备的 MSC 基板腔体厚度 (深度) 有限。因此MSC 三维基板仅适用于体积较小、精度要求不高的电子器件封装。
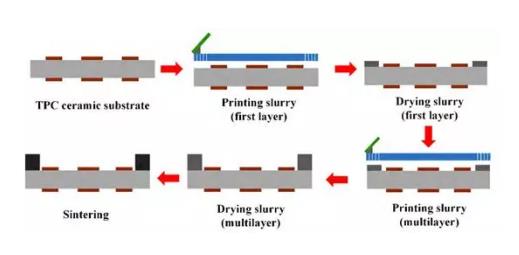
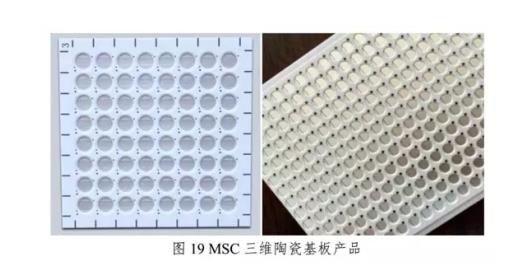
直接粘接三维陶瓷基板 (DAC)工艺流程和特点:
上述 HTCC、LTCC 及 MSC 基板线路层都采用丝网印刷制备,精度较低,难以满足高精度、高集成度封装要求,因此业界提出在高精度 DPC 陶瓷基板上成型腔体制备三维陶瓷基板。由于 DPC 基板金属线路层在高温 (超过 300°C) 下会出现氧化、起泡甚至脱层等现象,因此基于 DPC 技术的三维陶瓷基板制备必须在低温下进行。台湾瑷司柏公司 (ICP) 提出采用胶粘法制备三维陶瓷基板,样品如图 20 所示。首先加工金属环和 DPC 陶瓷基板,然后采用有机粘胶将金属环与 DPC 基板对准后粘接、加热固化,如图 21 所示。由于胶液流动性好,因此涂胶工艺简单,成本低,易于实现批量生产,且所有制备工艺均在低温下进行,不会对 DPC 基板线路层造成损伤。但是,由于有机粘胶耐热性差,固化体与金属、陶瓷间热膨胀系数差较大,且为非气密性材料,目前 DAC 陶瓷基板主要应用于线路精度要求较高,但对耐热性、气密性、可靠性等要求较低的电子器件封装。
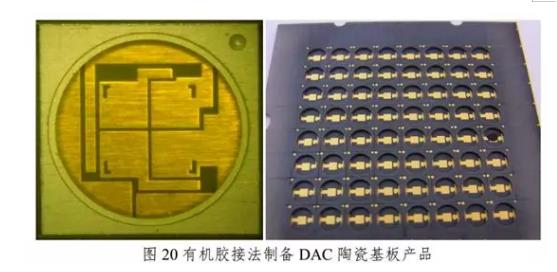
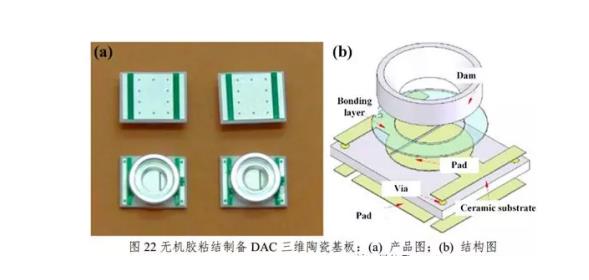
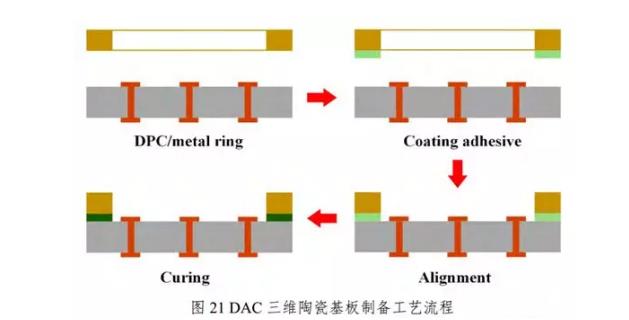
为了解决上述不足,业界进一步提出采用无机胶替代有机胶的粘接技术方案,大大提高了 DAC三维陶瓷基板的耐热性和可靠性。其技术关键是选用无机胶,要求其能在低温 (低于 200°C) 下固化;固化体耐热性好 (能长期耐受 300°C 高温),与金属、陶瓷材料粘接性好 (剪切强度大于 10 MPa),同时与金属环 (围坝) 和陶瓷基片材料热膨胀系数匹配 (降低界面热应力)。美国科锐公司 (Cree) XRE 系列产品封装基板既采用了该技术方案,如图 22。
多层电镀三维陶瓷基板 (MPC)工艺流程和特点
为了发挥 DPC 陶瓷基板技术优势 (高图形精度、垂直互连等),吴朝晖等人提出采用多次/层电镀增厚技术,在 DPC 陶瓷基板上直接制备具有厚铜围坝结构的三维陶瓷基板,如图 23 (a) 所示。其制备工艺与 DPC 基板类似,只是在完成平面 DPC 基板线路层加工后,再通过多次光刻、显影和图形电镀完成围坝制备 (厚度一般为 500μm ~ 700 μm),如图 24 所示。需要指出的是,由于干膜厚度有限 (一般为 50 μm ~ 80 μm),需要反复进行光刻、显影、图形电镀等工艺;同时为了提高生产效率,需要在电镀增厚围坝时提高电流密度,导致镀层表面粗糙,需要不断进行研磨,保持镀层表面平整与光滑。
MPC 基板采用图形电镀工艺制备线路层,避免了HTCC/LTCC 与 TPC 基板线路粗糙问题,满足高精度封装要求。陶瓷基板与金属围坝一体化成型为密封腔体,结构紧凑,无中间粘结层,气密性高。MPC 基板整体为全无机材料,具有良好的耐热性,抗腐蚀、抗辐射等。金属围坝结构形状可以任意设计,围坝顶部可制备出定位台阶,便于放置玻璃透镜或盖板,目前已成功应用于深紫外 LED封装和 VCSEL 激光器封装,已部分取代 LTCC 基板。其缺点在于:由于干膜厚度限制,制备过程需要反复进行光刻、显影、图形电镀与表面研磨,耗时长 (厚度为 600 μm 围坝需要电镀 10 h 以上),生产成本高;此外,由于电镀围坝铜层较厚,内部应力大,MPC 基板容易翘曲变形,影响后续的芯片封装质量与效率。
直接成型三维陶瓷基板 (DMC)工艺流程和特点
为了提高三维陶瓷基板生产效率,同时保证基板线路精度与可靠性,陈明祥等人提出制备含免烧陶瓷围坝的三维陶瓷基板,其样品如图 25 所示。为了制备具有高结合强度、高耐热性的陶瓷围坝,实验采用碱激发铝硅酸盐浆料(alkali-activated aluminosilicate cement paste, ACP) 作为围坝结构材料。围坝由偏高岭土在碱性溶液中脱水缩合而成,具有低温固化、耐热性好 (可长期耐受 500°C 高温)、与金属/陶瓷粘接强度高、抗腐蚀,物化性能稳定等优点,满足电子封装应用需求。DMC 基板制备工艺流程如图 26 所示,首先制备平面 DPC 陶瓷基板,同时制备带孔橡胶模具;将橡胶模具与 DPC 陶瓷基板对准合模后,向模具腔内填充牺牲模材料;待牺牲模材料固化后,取下橡胶模具,牺牲模粘接于 DPC 陶瓷基板上,并精确复制橡胶模具孔结构特征,作为铝硅酸盐浆料成型模具;随后将铝硅酸盐浆料涂覆于 DPC 陶瓷基板上并刮平,加热固化,最后将牺牲模材料腐蚀,得到含铝硅酸盐免烧陶瓷围坝的三维陶瓷基板。
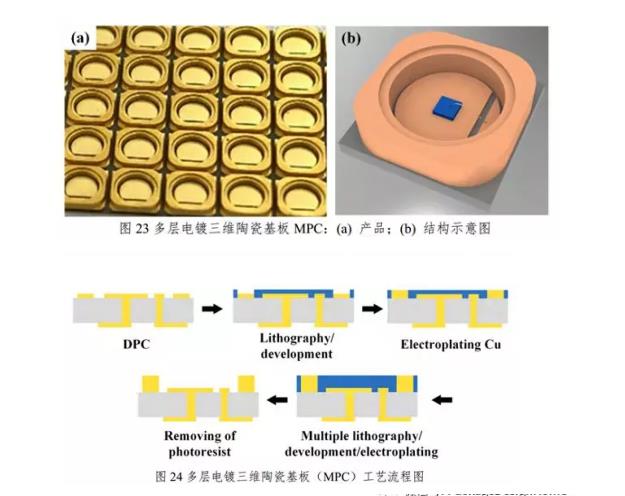
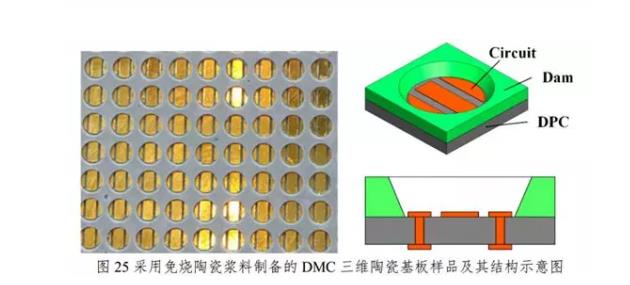
铝硅酸盐浆料固化温度低,对 DPC 陶瓷基板线路层影响极小,并与 DPC 基板制备工艺兼容。橡胶具有易加工、易脱模以及价格低廉等特点,能精确复制围坝结构 (腔体) 形状与尺寸,保证围坝加工精度。实验结果表明,腔体深度、直径加工误差均小于 30 μm,说明该工艺制备的三维陶瓷基板精度高,重复性好,适合量产。铝硅酸盐浆料加热后脱水缩合,主要产物为无机聚合物,其耐热性好,热膨胀系数与陶瓷基片匹配,具有良好的热稳定性;固化体与陶瓷、金属粘接强度高,制备的三维陶瓷基板可靠性高。围坝厚度 (腔体高度) 取决于模具厚度,理论上不受限制,可满足不同结构和尺寸的电子器件封装要求。
表 3 比较了上述不同三维陶瓷基板性能的一些基本性能。与表 2 重复或类似的数据不再列入。
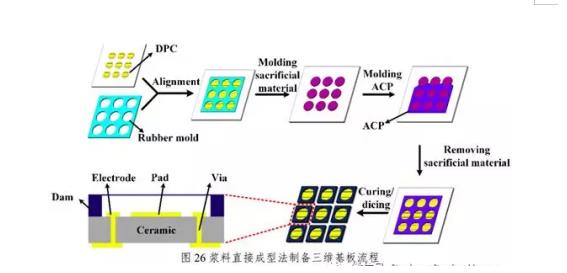
陶瓷基板发展趋势分析
陶瓷基板集成化:一般而言,TPC、DBC 和 AMB 陶瓷基板只适合制备单面线路层 (或双面线路层,但上下层不导通)。如果要实现上下层导通,需要先激光打孔 (孔径一般大于 200 μm),然后孔内填充金属浆料后烧结而成,孔内金属层导电、导热性差,基板可靠性低。HTCC/LTCC 基板采用多层生胚片叠加 (金属通孔对准) 后烧结制备,因此可实现基板内垂直互连,提高封装集成度,但HTCC/LTCC 基板电阻率较大,电流通载能力较低。DPC 陶瓷基板可以采用激光打孔 (孔径一般为60 μm ~ 120 μm) 和电镀填孔技术制备金属通孔,由于孔内电镀填充致密铜柱,导电导热性能优良,因而可实现陶瓷基板上下线路层垂直互连。在此基础上,通过电镀增厚等技术制备围坝,可得到含围坝结构的三维陶瓷基板;如果采用焊接/粘接技术实现多片 DPC 基板垂直集成,则可以进一步得到多层陶瓷基板 (Multilayer Ceramic Substrate, MLC,如图 37),满足功率器件三维封装和异质集成需求。
以上是小编分享的陶瓷基板的7大技术工艺类型,阐述了工艺的流程和特点,陶瓷基板逐渐往高功率、高集成化、高精密、精细化方方向发展。对技术的要求越来越高,也讲促进陶瓷基板不断上进。更多陶瓷基板pcb问题可以咨询金瑞欣特种电路。


 返回列表
返回列表
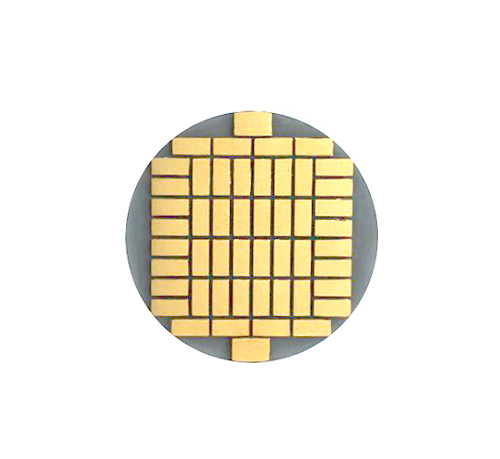
 网站首页
网站首页
 产品中心
产品中心
 关于金瑞欣
关于金瑞欣
 电话咨询
电话咨询