在当今电子设备追求轻薄化、多功能及低功耗的背景下,系统级封装(System in Package, SIP)技术已成为集成电路领域的重要发展方向。该技术通过将多个具有不同功能的有源芯片、无源元件以及微机电系统(MEMS)等,高密度地集成于一个封装体内,使之成为一个具备完整系统或子系统功能的标准化部件,从而有效实现系统功能的拓展、体积的缩小、重量的减轻与成本的优化,下面由深圳金瑞欣小编来跟大家讲解一下:

一、SIP技术对基板材料的核心性能要求
作为集成系统的物理承载与电气连接骨架,基板材料的性能直接决定了SIP的最终性能、可靠性与寿命。其核心要求可归纳为以下几点:
优异的电学性能:要求材料具备低介电常数与低介电损耗。前者能提升信号的传输速度,减少延迟;后者能显著降低高频信号传输过程中的能量损耗与热效应,确保信号完整性。
卓越的热管理能力:随着芯片堆叠与功率密度激增,散热成为SIP的关键挑战。基板材料需具备高热导率,以便快速导出芯片热量。同时,其热膨胀系数应与芯片材料(如硅、砷化镓)高度匹配,避免因温度循环产生热应力,导致焊点疲劳、界面分层或芯片损坏。
可靠的机械性能:基板需具备足够的弯曲强度与弹性模量,以确保在制造、组装及使用过程中保持结构完整,减小变形,防止破损。
二、SIP用先进陶瓷基板材料的演进与比较
陶瓷基板因其良好的综合性能,成为SIP,特别是高性能SIP的首选。传统氧化铝(Al?O?)陶瓷热导率偏低,而氧化铍(BeO)虽有高导热性但其毒性制约了应用。为此,氮化铝(AlN)与低温共烧陶瓷(LTCC)等先进材料应运而生。

1. 氮化铝(AlN)陶瓷:高功率散热的理想选择
氮化铝陶瓷以其卓越的导热性能脱颖而出,其热导率高达170-200 W/(m·K),是Al?O?的5-8倍。同时,其热膨胀系数(约4.2×10??/°C)与硅(Si)等半导体芯片非常接近,确保了优异的热匹配性。此外,AlN还具备高机械强度、良好的电绝缘性及适中的介电常数,使其非常适用于高功率、大尺寸及多引线芯片的SIP封装,是解决系统散热瓶颈的关键材料。
2. 低温共烧陶瓷(LTCC):高密度集成的多功能平台
LTCC技术是一种多层陶瓷共烧技术,其核心优势在于三维集成与设计灵活性。
高密度集成:允许在生瓷带中预先制造空腔和埋置电阻、电容、电感等无源元件,再通过叠层与共烧形成三维电路结构,极大提升了系统集成度与组装密度。
设计灵活:材料介电常数可调,并可混合使用不同介电特性的层板;同时,其低温工艺允许使用导电性极佳的金、银、铜作为布线材料,特别适合高频、高速电路应用。
良好匹配性:LTCC材料与半导体芯片热膨胀系数相近,且其填孔工艺提供了良好的垂直导热通路,综合性能均衡。
基于LTCC的SIP能够实现无源元件的集成化、布线的高密度化,并简化外围电路设计,是实现多功能、微波毫米波模块的重要技术路径。
三、未来展望:复合化是必然趋势
面对日益复杂的应用场景与性能极限的挑战,单一材料的性能已难以满足所有需求。未来,电子封装材料的发展将必然走向多相复合化。例如,在LTCC体系中引入高导热填料(如AlN颗粒)以提升其散热能力,或开发新型陶瓷-金属复合材料等,通过材料的创新组合,为下一代SIP技术提供更强大的基础支撑。
深圳市金瑞欣特种电路技术有限公司,位于深圳宝安,主要生产经营:氧化铝陶瓷基板、氮化铝陶瓷基板、陶瓷电路板、陶瓷pcb、陶瓷线路板、陶瓷覆铜基板、陶瓷基板pcb、DPC陶瓷基板、DBC陶瓷基板等。有需求的话,欢迎联系我们。


 返回列表
返回列表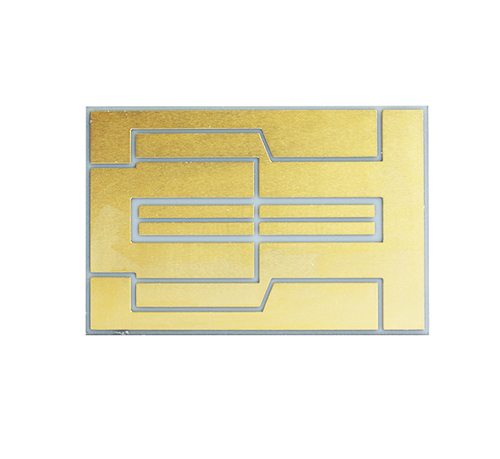

 网站首页
网站首页
 产品中心
产品中心
 关于金瑞欣
关于金瑞欣
 电话咨询
电话咨询